Polovodičové laserové odtahové zařízení způsobuje revoluci v ředění ingotů
Podrobný diagram
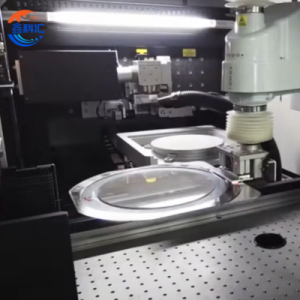
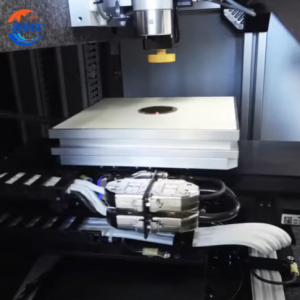
Představení produktu polovodičového laserového zařízení pro odpalování
Zařízení Semiconductor Laser Lift-Off Equipment je vysoce specializované průmyslové řešení určené pro přesné a bezkontaktní ztenčování polovodičových ingotů pomocí technik laserového ztenčování. Tento pokročilý systém hraje klíčovou roli v moderních procesech výroby polovodičových destiček (waferů), zejména při výrobě ultratenkých destiček pro vysoce výkonnou výkonovou elektroniku, LED diody a RF zařízení. Umožněním oddělení tenkých vrstev od objemových ingotů nebo donorových substrátů způsobuje zařízení Semiconductor Laser Lift-Off Equipment revoluci v ztenčování ingotů eliminací mechanického řezání, broušení a chemického leptání.
Tradiční ztenčování polovodičových ingotů, jako je nitrid galia (GaN), karbid křemíku (SiC) a safír, je často pracné, nehospodárné a náchylné k mikrotrhlinám nebo poškození povrchu. Naproti tomu zařízení Semiconductor Laser Lift-Off Equipment nabízí nedestruktivní a přesnou alternativu, která minimalizuje ztráty materiálu a povrchové napětí a zároveň zvyšuje produktivitu. Podporuje širokou škálu krystalických a složených materiálů a lze jej bezproblémově integrovat do linek na výrobu polovodičů v předprodeji nebo v polovině procesu.
Díky konfigurovatelným vlnovým délkám laseru, adaptivním zaostřovacím systémům a vakuově kompatibilním upínačům destiček je toto zařízení obzvláště vhodné pro řezání ingotů, vytváření lamel a oddělování ultratenkých vrstev pro vertikální struktury součástek nebo heteroepitaxní přenos vrstev.

Parametr polovodičového laserového odpalovacího zařízení
| Vlnová délka | IR/SHG/THG/FHG |
|---|---|
| Šířka impulsu | Nanosekunda, pikosekunda, femtosekunda |
| Optický systém | Pevný optický systém nebo galvanooptický systém |
| Fáze XY | 500 mm × 500 mm |
| Rozsah zpracování | 160 mm |
| Rychlost pohybu | Max. 1 000 mm/s |
| Opakovatelnost | ±1 μm nebo méně |
| Absolutní přesnost polohy: | ±5 μm nebo méně |
| Velikost oplatky | 2–6 palců nebo na míru |
| Řízení | Windows 10, 11 a PLC |
| Napětí zdroje napájení | AC 200 V ±20 V, jednofázové, 50/60 kHz |
| Vnější rozměry | 2400 mm (Š) × 1700 mm (H) × 2000 mm (V) |
| Hmotnost | 1 000 kg |
Princip fungování polovodičového laserového zařízení pro odpalování
Základní mechanismus zařízení pro odtahování polovodičových laserů spočívá v selektivním fototermálním rozkladu nebo ablaci na rozhraní mezi donorovým ingotem a epitaxní nebo cílovou vrstvou. Vysokoenergetický UV laser (obvykle KrF při 248 nm nebo UV lasery v pevné fázi kolem 355 nm) je zaostřován skrz průhledný nebo poloprůhledný donorový materiál, kde je energie selektivně absorbována v předem určené hloubce.
Tato lokalizovaná absorpce energie vytváří na rozhraní vrstvu plynné fáze o vysokém tlaku nebo tepelné roztažnosti, která iniciuje čisté oddělování horní vrstvy destičky nebo zařízení od základny ingotu. Proces je jemně laděn nastavením parametrů, jako je šířka pulzu, laserová hustota energie, rychlost skenování a ohnisková hloubka v ose z. Výsledkem je ultratenký plátek – často v rozsahu 10 až 50 µm – čistě oddělený od základního ingotu bez mechanického oděru.
Tato metoda laserového odlepování ingotů zabraňuje ztrátám v řezné spárě a poškození povrchu spojenému s řezáním diamantovým drátem nebo mechanickým lapováním. Zároveň zachovává integritu krystalu a snižuje požadavky na následné leštění, což z polovodičového laserového odlepovacího zařízení dělá převratný nástroj pro výrobu destiček nové generace.
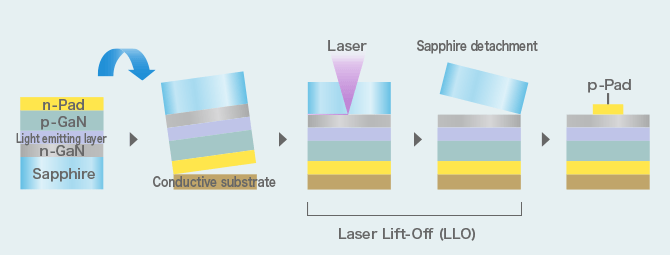
Aplikace zařízení pro odpalování polovodičových laserů
Zařízení pro polovodičové laserové řezání ingotů nachází široké uplatnění při ztenčování ingotů v řadě pokročilých materiálů a typů zařízení, včetně:
-
Ředění ingotů GaN a GaAs pro výkonová zařízení
Umožňuje vytváření tenkých destiček pro vysoce účinné výkonové tranzistory a diody s nízkým odporem.
-
Regenerace substrátu SiC a separace lamel
Umožňuje odlepování destiček od objemových SiC substrátů pro vertikální struktury součástek a opětovné použití destiček.
-
Krájení LED oplatek
Usnadňuje odlupování vrstev GaN z tlustých safírových ingotů pro výrobu ultratenkých LED substrátů.
-
Výroba RF a mikrovlnných zařízení
Podporuje ultratenké struktury tranzistorů s vysokou mobilitou elektronů (HEMT) potřebné v 5G a radarových systémech.
-
Epitaxní přenos vrstev
Přesně odděluje epitaxní vrstvy z krystalických ingotů pro opětovné použití nebo integraci do heterostruktur.
-
Tenkovrstvé solární články a fotovoltaika
Používá se k oddělení tenkých absorpčních vrstev pro flexibilní nebo vysoce účinné solární články.
V každé z těchto oblastí poskytuje polovodičové laserové odlepovací zařízení bezkonkurenční kontrolu nad rovnoměrností tloušťky, kvalitou povrchu a integritou vrstvy.
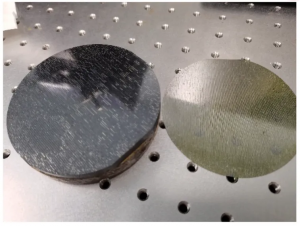
Výhody laserového ředění ingotů
-
Ztráta materiálu s nulovou řeznou spárou
Ve srovnání s tradičními metodami řezání destiček dosahuje laserový proces téměř 100% využití materiálu.
-
Minimální namáhání a deformace
Bezkontaktní odlepování eliminuje mechanické vibrace, čímž se snižuje prohnutí destičky a tvorba mikrotrhlin.
-
Zachování kvality povrchu
V mnoha případech není nutné lapování ani leštění po ztenčení, protože laserové odlepování zachovává integritu horního povrchu.
-
Vysoká propustnost a připravenost k automatizaci
Schopný zpracovat stovky substrátů za směnu s automatickým nakládáním/vykládáním.
-
Přizpůsobitelné různým materiálům
Kompatibilní s GaN, SiC, safírem, GaAs a nově vznikajícími materiály III-V.
-
Bezpečnější pro životní prostředí
Snižuje používání abraziv a agresivních chemikálií, které jsou typické pro ředění na bázi suspenze.
-
Opětovné použití substrátu
Dárcovské ingoty lze recyklovat pro několik cyklů odtahu, což výrazně snižuje náklady na materiál.
Často kladené otázky (FAQ) o zařízeních pro odpalování polovodičových laserů
-
Otázka 1: Jakého rozsahu tloušťky může zařízení pro odlepování polovodičových laserů dosáhnout u plátků destiček?
A1:Typická tloušťka řezu se pohybuje od 10 µm do 100 µm v závislosti na materiálu a konfiguraci.Q2: Lze toto zařízení použít k ztenčení ingotů vyrobených z neprůhledných materiálů, jako je SiC?
A2:Ano. Laděním vlnové délky laseru a optimalizací inženýrství rozhraní (např. obětních mezivrstev) lze zpracovávat i částečně neprůhledné materiály.Q3: Jak se zarovnává donorový substrát před laserovým odlepením?
A3:Systém využívá zarovnávací moduly založené na submikronovém vidění se zpětnou vazbou z referenčních značek a skenů odrazivosti povrchu.Q4: Jaká je očekávaná doba cyklu pro jednu operaci laserového odpalování?
A4:V závislosti na velikosti a tloušťce destičky trvají typické cykly 2 až 10 minut.Q5: Vyžaduje proces prostředí čistých prostor?
A5:I když to není povinné, doporučuje se integrace do čistých prostor pro udržení čistoty substrátu a výtěžnosti zařízení během vysoce přesných operací.
O nás
Společnost XKH se specializuje na high-tech vývoj, výrobu a prodej speciálního optického skla a nových krystalových materiálů. Naše produkty slouží optické elektronice, spotřební elektronice a armádě. Nabízíme safírové optické komponenty, kryty čoček mobilních telefonů, keramiku, LT, karbid křemíku SIC, křemen a polovodičové krystalové destičky. Díky odborným znalostem a nejmodernějšímu vybavení vynikáme ve zpracování nestandardních produktů s cílem stát se předním technologicky vyspělým podnikem v oblasti optoelektronických materiálů.










